等离子清洗正在推动半导体行业新发展的变革。它提供了增强型的清洁,表面改性和先进的蚀刻工艺。通过利用电离气体,这种方法不仅能以令人难以置信的效率去除污染,而且还能控制表面状况,以提高附着力。
等离子清洗技术在半导体封装主要应用工序:

倒装芯片(flip chip)
使用大气压氢气和氩气等离子体去除铟、锡和铜微凸块阵列中的氧化物
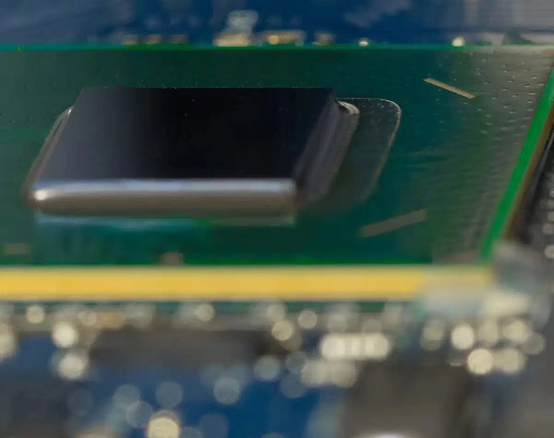
底部填充(Underfill)
在分配底部填充之前激活 BGA、CSP 或倒装芯片下方的表面
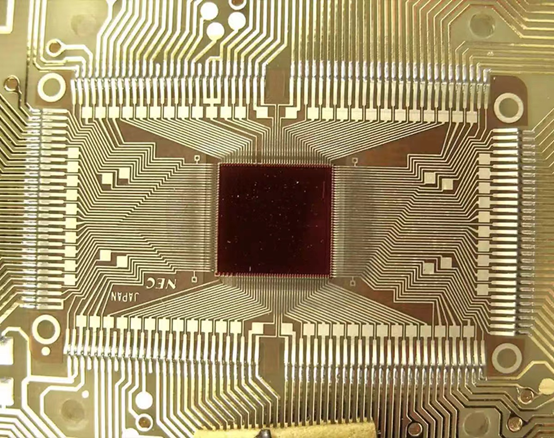
引线键合(Wire bond)
在进行引线键合之前,清除引线框架上键合焊盘上的有机污染物

Molding
在将芯片封装在环氧树脂模具中之前,激活引线框架和其他封装以进行粘合
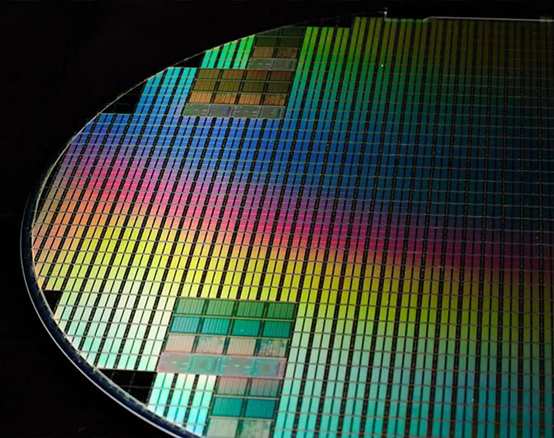
晶圆混合键合(hybrid bonding)
激活玻璃膜以进行直接熔融粘合,无需在晶圆表面添加任何颗粒
(1)晶圆清洗:清除残留光刻胶
(2)封装点银胶前:使工件表面粗糙度及亲水性大大提高,有利于银胶平铺及芯片粘贴,同时可大大节省银胶的使用量,降低成本
(3)引线键合前清洗: 清洁焊盘,改善焊接条件,提高焊接可靠性及良率
(4)塑封:提高塑封料与产品粘结的可靠性,减少分层风险
(5)引线框架的洁净:微电子封装后容易出现密封性能变差与慢性渗气现象,同时也会影响芯片的粘接和引线键合质量 ,如何确保引线框架的洁净是保证封装可靠性与良率的关键。经等离子表面处理机机清洗后,引线框架表面净化和活化的效果成品良率比传统的湿法清洗会有极大的提高,并且免除了废水排放,降低化学药水采购成本。
(6) 集成电路引线键台的质量:对微电子器件的可靠陛有决定性影响,键合区必须无污染物并具有良好的键合特性。污染物的存在,如氯化物、有机残渣等都会严重削弱引线键台的拉力值。